本(ben)文作者:李笑寅
来源:硬AI
隔夜美股市场,半导体(ti)巨(ju)头台积(ji)电盘中市值站上1万亿美元,台股股价也在周一创(chuang)下历史新(xin)高,显示市场对高端芯片尤其是AI芯片的需求依然旺盛。
7月8日,投行Bernstein分析(xi)师Mark Li、Stacy A. Rasgon等人发布研报(bao),总结了到2027年的AI芯片技术变革路线图,并就设计架构、晶圆节点、HBM和高级封装这四个领域进行了分析(xi),并讨论了其可(ke)能带来的影响。
AI芯片加速迭代,英伟(wei)达或成最大赢家

Bernstein认为(wei),AI芯片将加速发展,尤其是英伟(wei)达已经将迭代速度加快(kuai)到“一年一更”。
技术路线图一显示,英伟(wei)达从Blackwell到Rubin的飞跃性变化(hua),包括架构、节点、HBM和封装在大约1年内全部改变――节点从N4到N3,HBM从3E到4,封装尺寸从更小(单个CoWoS晶圆容纳16个B100/B200)到更大(单个CoWoS晶圆上容纳高个位数(shu)到10个Rubin)。
此外,英伟(wei)达HBM从8hi/192GB升级到12hi/288GB的更新(xin)将在6个月内完成。
相比之下,AMD的步伐要稍慢一些:MI325X约比MI300X晚一年推出,并且只会升级内存;到2025年,MI350X将主要升级到N3节点,但内存和容量保持不变,仍为(wei)HBM3E 288GB。
报(bao)告指出,这将带来第(di)一个影响:随着AI芯片加速迭代,英伟(wei)达相较(jiao)于其他(ta)厂商的领先(xian)优势将进一步扩(kuo)大。

第(di)二个影响是,CPU与GPU整合、内存和逻(luo)辑整合的趋势。比如英伟(wei)达就在其GB200中集成了CPU和GPU,帮助(zhu)其基(ji)于Arm的CPU利用GPU领域的领先(xian)优势。
技术路线图三显示,为(wei)了进一步推动数(shu)据传输的发展,HBM4可(ke)能会开始提供基(ji)础芯片基(ji)础上的客户定制服务,由于其基(ji)础裸(luo)片(逻(luo)辑裸(luo)片)定制化(hua)需要更长的生产周期,因此在HBM内部进行逻(luo)辑和存储的整合或许会成为(wei)一大趋势。
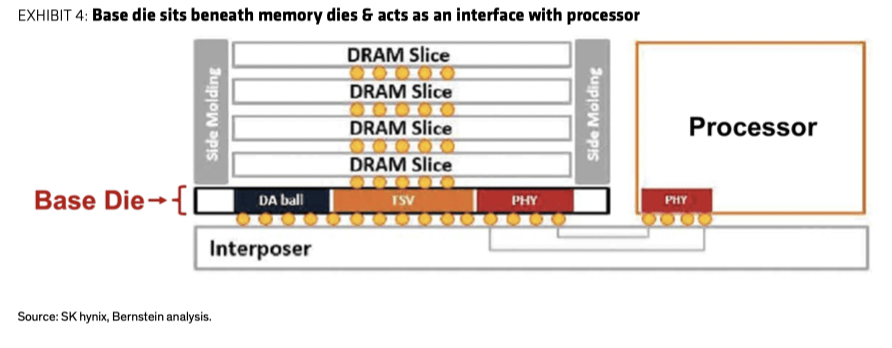
台积(ji)电的先(xian)进封装优势料将延续
报(bao)告指出,台积(ji)电的技术优势仍将延续下去,从CoWoS-S发展到CoWoS-L。
据悉,CoWoS-S整个中间件都使用硅,而CoWoS-L仅在密集金属线穿过的区域使用硅作为(wei)“桥(qiao)梁”,其余部分则用模塑化(hua)合物代替。
报(bao)告预计,未来几乎所有的AI芯片都将使用台积(ji)电的CoWoS进行封装,预计客户下一步将拓展至微软(部分通过Marvell)和Meta(通过博通)。这也将带来第(di)三大影响:随着技术的不断进步和客户群的不断扩(kuo)大,台积(ji)电在先(xian)进封装领域的领先(xian)地位即使不会扩(kuo)大,也会保持下去。
第(di)四,希望三星能及时跟上HBM3E的步伐。目前,三星尚未宣布其HBM3E的认证,特(te)别是获得英伟(wei)达的认证。
报(bao)告认为(wei),尽(jin)管三星在HBM3E的起步较(jiao)晚,但HBM3E的窗口期仍将为(wei)三星提供追赶的机会。英伟(wei)达在2025年的几乎所有芯片以及2026年其他(ta)厂商的芯片,很可(ke)能仍将使用HBM3E。
键合技术需求前景乐观、ASIC市场扩(kuo)张
随着节点过渡的持续,报(bao)告预计,AI将使N2成为(wei)一个“超级节点”,但这低估了产量和成本(ben)负担――随着水平扩(kuo)大,先(xian)进封装奖变得越来越困难――这使得键合技术、尤其是混合键合技术,在垂直堆叠领域中变得至关重要。
Bernstein对键合技术的长期前景持结构性乐观态度。报(bao)告认为(wei)第(di)五(wu)点影响即为(wei):AI芯片和其他(ta)相关应用(晶圆到晶圆、芯片到晶圆或芯片到芯片)将带来更大的键合技术市场,
第(di)六,面(mian)板级封装 (PLP) 比晶圆级封装更能横向扩(kuo)展封装,因前者能保证更好的水平可(ke)扩(kuo)展性,但这一变革需努(nu)力,所需时间可(ke)能要比预期的久。
报(bao)告认为(wei),三星拥(yong)有晶圆和面(mian)板,并正试图通过PLP创(chuang)造领先(xian)优势,在这方面(mian)应该比英特(te)尔和台积(ji)电更有优势。
最后,对于ASIC芯片提供商而言,AI芯片的激增将吸引新(xin)的进入者,同时也将极大地拓展市场。
报(bao)告表示,受市场增长的吸引,许多公(gong)司(si)正在进入ASIC(高性能专用集成电路)芯片领域,因其硬件规格更为(wei)简单,同时在工作效(xiao)率和成本(ben)上也具有优势,被视作GPU可(ke)行的替代品,包括亚马(ma)逊、微软、Meta在内的科(ke)技巨(ju)头都在开发ASIC芯片。
不过,由于ASIC芯片的受众大多是互联(lian)网公(gong)司(si)或过去没有太多经验的公(gong)司(si),他(ta)们需要ASIC服务供应商帮助(zhu)开发定制芯片。
报(bao)告指出,目前博通在这一领域明显处于领先(xian)地位,其收(shou)入高达数(shu)十亿美元,客户包括谷(gu)歌、Meta等,此外,因在SerDes IP和先(xian)进节点封装方面(mian)技术能力较(jiao)强,联(lian)发科(ke)也具备一定竞争力。